全反射荧光X射线分析TXRF
为了防止半导体制造过程中的污染
半导体制造中清洁度决定了产品的品质,所以生产过程中的污染检测非常重要
所以需要可以快速的,高精度的,检测出多种元素的分析方法很重要。
为了防止半导体制造过程中的污染
半导体制造中清洁度决定了产品的品质,所以生产过程中的污染检测非常重要 所以需要可以快速的,高精度的,检测出多种元素的分析方法很重要。如果有类似要解决的问题,请考虑以下NTT-AT的权反射荧光X射线分析!
现有的分析方式是否有以下问题呢
- 分析时间过长
- 精度不够
- 污染点难确定
- 检测出的元素种类不够多
- 不同种类衬底或带膜衬底无法检测。
NTT-AT的全反射荧光X射线的分析的话
迅速
检测品收到后的1-2个工作日内可以完成检测高精度
精度达到109atoms/cm2是非破坏・非接触检测,不需要繁杂的前序处理,减少污染
通过取定点来分析,可以确定污染部位。
检测元素种类多
可同时分析多种元素。(※)还支持不同种类的彻底(蓝宝石、GaAs、玻璃)和带膜衬底(有机膜、金属膜等)的检测
※其他小尺寸的也可以具体咨询
可测试的晶圆的尺寸种类多
2英寸~12英寸都可以检测※可检测元素也有限制,具体请咨询我们。
分析的流程
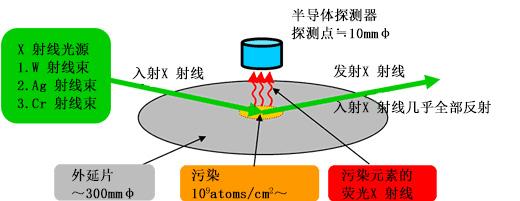
图1 装置概要
因为有3个种类的X射线源(3种beam),W beam无法测出的钠(Na)、钼(Mo)等元素也可以检测。
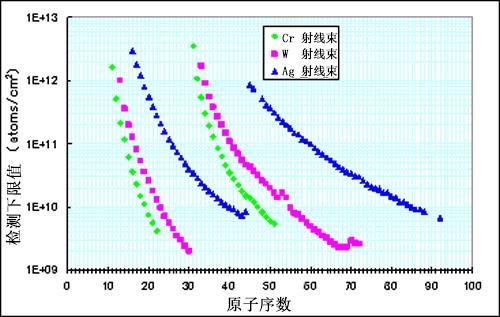
图2 全反射荧光X射线分析的检测下限值(硅晶圆)
可测定的元素

具体关于可测定的元素请咨询我们。
3种X射线源的可测定元素
| Cr Beam | Na~Ti及Ga~Ba (特别是对Na~Al、P效果更好) |
|---|---|
| W beam | Al~Zn及びAs~Hf (特别是对K~Zn效果更好) |
| Ag beam | S~U (特别是对As、Zr、Mo、Ta、W、Br、Pt、Au效果更好) |
适用例
SiC 衬底表面的金属污染测定实例
用TXRF,ICP-MS 来测试的第三代功率半导体的衬底表面的极微量金属污染检测实例

